3D封装材料技术
出处:xukaiguo 发布于:2010-08-13 09:53:40
随着移动电话等电子器件的不断飞速增长,这些器件中安装在有限衬底面积上的半导体封装也逐渐变小变薄。3D封装对减少装配面积非常有效。此外,系统级封装(SiP)技术(将二个或多个芯片安装在一个封装件中)对于提高处理速度和改善功耗的作用显着(图1)。为满足这一要求,不仅是每一种封装材料的特性非常重要,而且这些材料的组合也变得很重要。

本文重点介绍了材料、材料设计技术以及二者的结合,例如多芯片叠层封装、用于堆叠封装的环氧模塑料和衬底以及用于先进倒装芯片封装的底充胶材料。
3D封装用的先进材料技术
先进封装(包括3D封装)将用到各种不同的材料。例如前道材料中的低K材料、缓冲涂层和CMP研磨料,后道材料中的芯片键合膜、浆料、环氧模塑料、液态模封材料、衬底、阻焊剂等等。采用这些材料可以制作各种各样的先进封装。
用于多芯片叠层封装的芯片键合膜
存储器件广泛关注多芯片叠层封装能否实现性能更高、体积更小且更薄。图2(上)示出了多芯片叠层封装的典型结构和发展趋势。此时,芯片键合膜(DAF)的性质对提高封装性能极为重要。晶圆厚度与日俱减,堆叠芯片的数目则不断增加。由此产生了下列问题(图2下):DAF层压DAF后薄晶圆的翘曲;将芯片粘到衬底后封装的翘曲;热循环测试过程中的分层和芯片破裂。
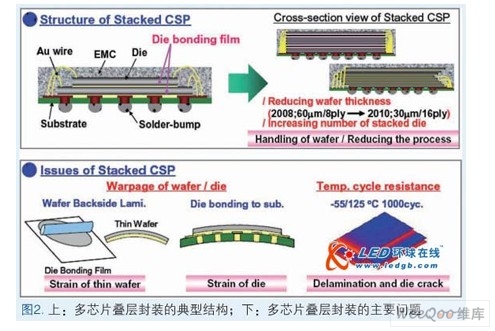
为了解决这些问题,研发了用于DAF的新颖聚合物合金系统。这一材料的弹性模量低,抗热性能好,能有效地减少叠层CSP的翘曲和热应力。
堆叠封装(PoP)用的环氧模塑料和衬底
PoP是堆积一个或多个芯片封装的安装形式。一般说来,PoP是将存储器封装堆叠在逻辑封装之上,以节省PCB空间。由于在PoP中的总封装高度增加了,必须尽可能减薄衬底和模塑材料的厚度(图3)。较薄封装的麻烦之处是PoP的连接问题,这一点在顶层封装和底层封装的翘曲程度不一样时尤为严重。所以,控制或减少每一封装的翘曲很重要。由于衬底、环氧模塑料(EMC)和底充胶材料(UF)的热膨胀性质直接影响封装的翘曲,因此,调整这些材料的性质比过去更为重要。

衬底和EMC的热膨胀系数(CTE)对封装的翘曲有直接影响。用新树脂系材料可以开发出适合于薄封装的低热膨胀系数衬底和高热膨胀系数EMC.
先进倒装芯片封装用的底充胶材料
如表1所示,倒装芯片封装的发展趋势是密度更高、芯片与衬底间间隙更窄、芯片尺寸更大、速度更快(更低k值)。低应力和窄间隙填充将来对底充胶材料越来越重要。另外,对超窄间隙封装和硅通孔(TSV)封装来说,迫切需要像不流动的底充胶材料和底充胶膜等预涂材料。正在开发满足这一需求的新颖高强度树脂系材料,这些材料对减少低k大芯片的破裂很有用。开发的底充胶膜特别适用于减少一些综合工艺步骤。
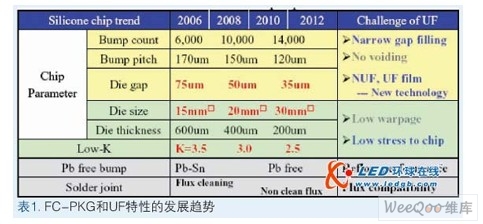
未来封装用的先进材料
3D安装用的新型衬底一般为超薄多层板。此材料的主要特点是:优良的静态弯曲能力;高抗热性;多层工艺时极好的尺寸稳定性。采用这些材料可以为3D安装PWB实现又薄又能弯曲的多层板。
开发了适用于低温再流焊工艺的新型导电浆料。这种新颖浆料是由低熔点金属和高抗热性热固树脂系组成。它形成金属键合和树脂带,能增强150℃再流焊工艺后的互连(图4)。金属键合减少了连接电阻,树脂带提高了TCT中连接的可靠性。采用此浆料可以方便地降低再流焊温度,以减少超薄封装的翘曲。
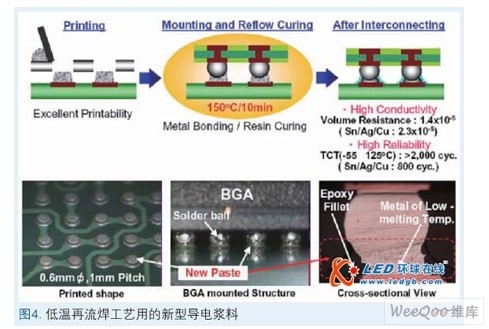
结论
SiP、3D封装将广泛用于各个电子学领域。新型材料包括了多芯片叠层封装用的芯片键合膜、PoP用的衬底和环氧模塑料、先进倒装芯片封装用的底充胶材料、3D安装用的新型衬底和低温再流焊工艺用的新型导电胶等。对3D封装材料的研究和探讨将提高3D封装性能并降低成本。
3D封装
当追随摩尔定律成为产业共识,More Moore的提出似乎又为芯片制造业的发展增添了些许亮色。一般来说,More Moore指芯片特征尺寸的不断缩小,它包括两方面:为提高密度、性能和可靠性在晶圆水平和垂直方向上继续缩小特征尺寸;采用3D结构等工艺技术以及新材料的运用来影响晶圆的电学性能。
随着消费电子设计降低到45nm甚至更小节点,为了在芯片内塞进更多功能,3D封装应运而生。手机是加速开发3D封装的主动力。手机已从低端向高端发展,要求体积小,重量轻且功能多。为此,高端手机用芯片必须具有强大的内存容量,于是诞生了芯片堆叠的封装(SDP),如多芯片封装(MCP)和堆叠芯片尺寸封装(SCSP)等;另外,在2D封装中需要大量长程互连,导致电路RC延迟的增加。为了提高信号传输速度,必须降低RC延迟。可用3D封装的短程垂直互连来替代2D封装的长程互连。
3D封装技术优势众多:
在尺寸和重量方面,3D设计替代单芯片封装缩小了器件尺寸、减轻了重量。与传统封装相比,使用3D技术可缩短尺寸、减轻重量达40-50倍;
在速度方面,3D技术节约的功率可使3D元件以每秒更快的转换速度运转而不增加能耗,寄生性电容和电感得以降低;
3D封装更有效的利用了硅片的有效区域,与2D封装技术相比,3D技术的硅片效率超过100%;
在芯片中,噪声幅度和频率主要受封装和互连的限制,3D技术在降低噪声中起着缩短互连长度的作用,因而也降低了互连伴随的寄生性。
电路密度的提高意味着提高功率密度。采用3D技术制造元器件可提高功率密度,但必须考虑热处理问题。一般需要在两个层次进行热处理,是系统设计,即将热能均匀的分布在3D元器件表面;第二是采用诸如金刚石低热阻基板,或采用强制冷风、冷却液来降低3D元器件的温度。为了持续提高电路密度、性能和降低成本,芯片尺寸不断缩小,意味着设计复杂度的提高。然而,3D技术目前只完成了少量复杂的系统及元器件,因此还要改进设计以解决系统复杂度不断增加的问题。
任何一种新技术的出现,其使用都存在着预期高成本的问题,3D技术也不例外。影响叠层成本的因素有:叠层高度及复杂性;每层的加工步骤数目;叠层前在每块芯片上采用的测试方法;硅片后处理等等。
3D封装改善了芯片的许多性能,如尺寸、重量、速度、产量及耗能。当前,3D封装的发展有质量、电特性、机械性能、热特性、封装成本、生产时间等的限制,并且在许多情况下,这些因素是相互关联的。3D封装开发如何完成、什么时候完成?大多数IC认为可能会经历以下几个阶段。具有TSV和导电浆料的快闪存储器晶圆叠层很可能会发展,随后会有表面凸点间距小至5μm的IC表面-表面键合出现。,硅上系统将会发展到存储器、图形和其它IC将与微处理器芯片相键合。
版权与免责声明
凡本网注明“出处:维库电子市场网”的所有作品,版权均属于维库电子市场网,转载请必须注明维库电子市场网,https://www.dzsc.com,违反者本网将追究相关法律责任。
本网转载并注明自其它出处的作品,目的在于传递更多信息,并不代表本网赞同其观点或证实其内容的真实性,不承担此类作品侵权行为的直接责任及连带责任。其他媒体、网站或个人从本网转载时,必须保留本网注明的作品出处,并自负版权等法律责任。
如涉及作品内容、版权等问题,请在作品发表之日起一周内与本网联系,否则视为放弃相关权利。
- 隔离变压器的特点与作用2024/4/8 17:20:17
- lms算法基本思想及原理2024/3/26 18:00:07
- LM393比较器工作原理2024/3/25 17:27:43
- 蜂鸣器的作用及用途介绍2024/3/21 16:52:43
- Excelpoint - 浅谈因电迁移引发的半导体失效2024/3/5 16:05:20









