采用LFCSP和法兰封装的RF放大器的热管理计算
出处:EEWORLD 发布于:2019-12-28 14:59:00
简介
射频(RF)放大器可采用引脚架构芯片级封装(LFCSP)和法兰封装,通过成熟的回流焊工艺安装在印刷电路板(PCB)上。PCB不仅充当器件之间的电气互联连接,还是放大器排热的主要途径(利用封装底部的金属块)。
本应用笔记介绍热阻概念,并且提供一种技术,用于从裸片到采用LFCSP或法兰封装的典型RF放大器的散热器的热流动建模。
热概念回顾
热流
材料不同区域之间存在温度差时,热量从高温区流向低温区。这一过程与电流类似,电流经由电路,从高电势区域流向低电势区域。
热阻
所有材料都具有一定的导热性。热导率是衡量材料导热能力的标准。热导率值通常以瓦特每米开尔文(W/mK)或瓦特每英寸开尔文(W/inK)为单位。如果已知材料的热导率,则采用以下公式,以C/W或K/W为单位计算材料单位体积的热阻(θ):

(1)
其中:
Length表示材料的长度或厚度,以米为单位。
k为材料的热导率。
Area表示横截面积,以m2为单位。
温度
利用热流量等效于电流量的类比,本身具备热阻且支持热流流动的材料的温差如下:
?T = Q × θ(2)
其中:
?T表示材料不同区域之间的温差(K或°C)。
Q表示热流(W)。
θ表示材料的热阻(C/W或K/W)。
器件的热阻
器件的热阻相当复杂,往往与温度呈非线性关系。因此,我们采用有限元分析方法建立器件的热模型。红外摄影技术可以确定器件连接处的温度和操作期间封装的温度。基于这些分析和测量结果,可以确定等效的热阻。在对器件实施测量的特定条件下,等效热阻是有效的,一般是在操作温度下。
参考表1,查看典型的RF放大器的额定值表。
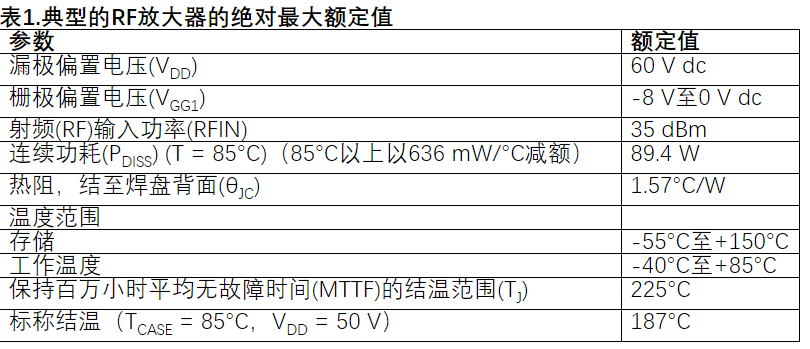
对于LFCSP和法兰封装,假定封装外壳是封装底部的金属块。
结温
在给定的数据手册中,会在额定值表中给出每个产品的结温(基于器件的半导体工艺)。在表1中,指定的维持百万小时MTTF的结温为225℃。指定的这个温度一般适用于氮化镓(GaN)器件。超过这个限值会导致器件的寿命缩短,且出现性的器件故障。
工作温度范围
器件的工作温度(TCASE)已在封装底座上给出。TCASE是封装底部金属块的温度。工作温度不是器件周围空气的温度。
如果已知TCASE和PDISS,则很容易计算得出结温(TJ)。例如,如果TCASE=75°C,PDISS=70 W,则可以使用以下公式计算TJ:
TJ = TCASE + (θJC × PDISS)
= 75°C + (1.57°C/W × 70 W)
= 184.9°C
考量到器件的可靠性时,TJ是重要的规格参数,决不能超过此数值。相反,如果可以通过降低PDISS,使TJ保持在可允许的水平之下,则TCASE可以超过指定的额定值。在此例中,当外壳温度超过指定的值85°C时,可使用减额值636 mW/°C来计算可允许的PDISS。例如,使用表1中的数据,当PDISS的限值为83 W时,可允许的TCASE为95°C。PDISS可使用以下公式计算:
PDISS = 89.4 W ? (636 mW/°C × 10°C)
= 83 W
使用此PDISS 值,可以计算得出225°C结温,计算公式如下:
TJ = TCASE + (θJC × PDISS)
= 95°C + (1.57°C/W × 83 W)(3)
器件和PCB环境的热模型
为了充分了解器件周围的整个热环境,必须对器件的散热路径和材料进行建模。图1显示了安装在PCB和散热器上的LFCSP封装的截面原理图。在本例中,裸片生热,然后经由封装和PCB传输到散热器。要确定器件连接处的温度,必须计算热阻。利用热阻与热流,可计算得出结温。然后将结温与指定结温进行比较,以确定器件是否可靠地运行。
在图1中,器件连接处到散热器的散热路径定义如下:
θJA是器件连接处到封装顶部周围空气的热阻。
θJC是连接处到外壳(封装底部的金属块)的热阻。
θSN63是焊料的热阻。
θCU是PCB上镀铜的热阻。
θVIACU是通孔上镀铜的热阻。
θVIASN63是通孔中填充的焊料的热阻。
θPCB是PCB层压材料的热阻。
在典型电路板中,包含多个通孔和多个PCB层。在计算系统截面的热阻时,会使用热电路计算各个热阻,并将串联热阻与并联热阻结合起来,以此确定器件的总热阻。
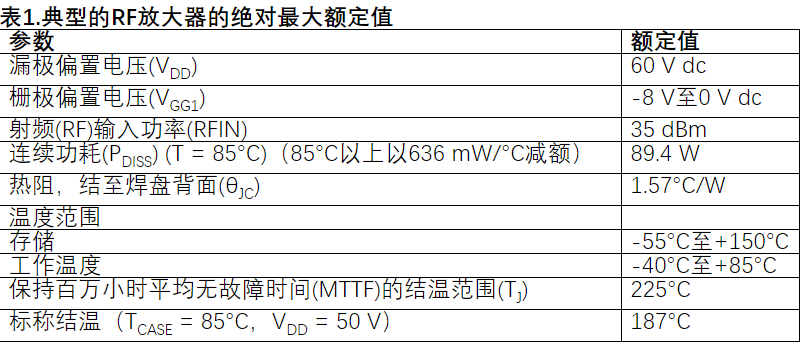
图1.安装在PCB和散热器上的LFCSP封装的热模型系统的热阻计算
对于每个散热路径,都使用公式1来计算其热阻。要计算得出各个热阻值,必须已知材料的热导率。参见表2,查看PCB总成中常用材料的热导率。

图2基于图1中所示的热模型,显示等效的热电路。TPKG表示封装底部的温度,TSINK表示散热器的温度。在图2中,假设封装(TA)周围的环境空气温度恒定不变。对于外层包有外壳的真实总成,TA可能随着功耗增加而升高。本分析忽略了散热路径至环境空气的温度,因为对于具有金属块的LFCSP和法兰封装,θJA要远大于θJC。

图2.等效的热电路
热阻示例:HMC408LP3评估板
HMC408LP3功率放大器采用一块0.01英寸厚,由Rogers RO4350层压板构成的评估板。图3所示的接地焊盘面积为0.065 × 0.065英寸,上有5个直径为0.012英寸的通孔。电路板顶部和底部分别有1盎司镀铜(0.0014英寸厚)。通孔采用?盎司铜进行镀层(0.0007英寸厚)。装配期间,会在通孔中填塞SN63焊料。分析显示,几乎所有的热流都会流经焊料填塞的通孔。因此,在本分析中,余下的电路板布局都可忽略。

图3.接地焊盘布局
各个热阻都使用公式1计算得出。计算θSN63时,采用的SN63焊料的热导率为1.27 W/inK,长度(或者焊接点的厚度)为0.002英寸,焊接面积为0.004225英寸(0.065英寸× 0.065英寸)。

(4)
接下来,以相似方式计算PCB顶部的铜镀层的值。铜镀层的热导率为10.008 W/inK,长度为0.0014 英寸(1盎司铜),镀层面积为0.00366平方英寸(in2)。

(5)
对于通孔上铜镀层的面积,采用以下公式进行计算面积 = π × (rO2 – rI2)(6)
其中:
rO表示外径。
rI表示内径。
外径为0.006英寸,内径为0.0053英寸时,计算得出的面积为0.00002485 in2。通孔的长度为板的厚度(0.01英寸),铜的热导率为10.008 W/inK。
(7)
因为并排存在5个通孔,所以热阻要除以5。所以,θVIACU = 8.05°C/W。
以相似方式计算得出通孔的填塞焊料的值。

(8)
因为存在5个填塞通孔,所以等效热阻为θVIASN63 = 17.85°C/W。
接下来,使用0.01英寸长度、0.016 W/inK的Rogers RO4350热导率,以及0.00366 in2面积计算PCB的热阻。
(9)
在图2所示的等效热电路中,三个热阻(θPCB、θVIACU和θVIASN63)并联组合之后为5.37°C/W。在通孔中填塞焊料之后,热阻从8.05°C/W降低至5.37°C/W。,加上热阻串联的值,可以得出整个PCB总成的热阻。
θASSY = θSN63 + θCU + θEQUIV + θCU = 0.372 + 0.038 + 5.37 + 0.038 = 5.81°C/W(10)其中,θASSY表示总成的热阻。
确定功耗
热阻值确定后,必须确定热流(Q)值。对于RF器件,Q的值表示输入器件的总功率和器件输出的总功率之间的差值。总功率包括RF功率和直流功率。
Q = PINTOTAL ? POUTTOTAL = (PINRF + PINDC) ? POUTRF(11)其中:
PINTOTAL表示直流功率和RF输入功率之和。
POUTTOTAL表示器件输出的功率,与POUTRF相同。
PINRF表示RF输入功率。
PINDC表示直流输入功率。
POUTRF表示传输至负载的RF输出功率。
图4.HMC408LP3功耗与输入功率
对于HMC408LP3功率放大器,使用公式11来计算图4中所示的PDISS的值。图4显示了放大器的以下特性:
器件消耗约4 W功率,无RF输入信号。
采用RF信号时,PDISS的值由频率决定。
存在某一个输入功率,器件的功耗。
根据等效热阻、θTOTAL和Q,可以使用以下公式计算得出结温ΔT = Q × θTOTAL(12)
θTOTAL = θASSY + θJC = 5.81 + 13.79 = 19.6°C/W(13)对于无RF输入功率的静止状态,Q = 4 W,且
?T = 4.0 × 19.6 = 78.4°C(14)
因为指定的HMC408LP3的结温为150°C,所以在PDISS = 4 W时,散热器的温度必须≤71.6°C(也就是说,78.4°C + 71.6°C = 150°C)。
HMC408LP3功率放大器正常运行时(例如,输入功率≤ 5 dBm),功耗小于4 W,这表示散热器的温度可以稍微高于71.6°C。但是,如果放大器在深度压缩环境中工作,且输入功率等效于15 dBm,则PDISS升高,且要求散热器的温度低于71.6°C。
image.png
可靠性
组件的预期寿命与工作温度密切相关。在低于结温的温度下运行可以延长器件的使用寿命。超过结温会缩短使用寿命。因此,实施热分析可以确保在预期的操作条件下不会超过指定的结温。
结论
使用采用LFCSP和法兰封装的低结温表贴RF功率放大器来围装热阻迫使PCB不仅要充当器件之间的RF互连,还要用作导热路径以导走功率放大器的热量。
因此,θJC 取代θJA,成为衡量LFCSP或法兰封装的重要热阻指标。
在这些计算中,关键的指标是RF放大器的结温或通道温度(TJ)。只要不超过结温,那么其他标称限值,例如TCASE,则可以高于限值。
版权与免责声明
凡本网注明“出处:维库电子市场网”的所有作品,版权均属于维库电子市场网,转载请必须注明维库电子市场网,https://www.dzsc.com,违反者本网将追究相关法律责任。
本网转载并注明自其它出处的作品,目的在于传递更多信息,并不代表本网赞同其观点或证实其内容的真实性,不承担此类作品侵权行为的直接责任及连带责任。其他媒体、网站或个人从本网转载时,必须保留本网注明的作品出处,并自负版权等法律责任。
如涉及作品内容、版权等问题,请在作品发表之日起一周内与本网联系,否则视为放弃相关权利。
- plc是什么工作原理和结构组成2024/4/25 17:27:54
- 直流电机工作原理与控制电路解析2024/4/25 17:21:49
- TI - MCU 如何在机器人电机控制设计中提高系统性能2024/4/24 15:56:54
- 三相电机:类型和工作原理2024/4/22 16:56:46
- 直流发电机组件2024/4/15 17:35:29
- 英特尔数据存储如何操作和实现
- 什么是微动开关_微动开关有什么用_微动开关使用方法
- VCC,VDD,VEE,VSS在电源原理图中有什么区别?
- 低压配电系统设计规范_低压配电系统设计注意事项
- xEV 主逆变器电源模块中第四代 SiC MOSFET 的短路测试
- 光耦详细应用教程
- 定义绝缘耐久性评估的电压脉冲测试要求
- 采用沟槽MOS结构,使存在权衡关系的VF和IR相比以往产品得到显著改善 ROHM推出实现业界超快trr的100V耐压SBD“YQ系列”
- NOVOSENSE - 纳芯微推出车规级温湿度传感器NSHT30-Q1,助力汽车智能化发展
- Keysight - EV 电池设计创新:扩大续航里程、延长电池寿命









