ST - 碳化硅MOSFET的短路实验性能与有限元分析法热模型的开发
出处:维库电子市场网 发布于:2019-03-08 15:24:11
就目前而言,碳化硅(SiC)材料具有的的电学和热学性质,使得碳化硅功率器件在性能方面已经超越硅产品。在需要高开关频率和低电能损耗的应用中,碳化硅MOSFET正在取代标准硅器件。半导体技术要想发展必须解决可靠性问题,因为有些应用领域对可靠性要求十分严格,例如:汽车、飞机、制造业和再生能源。典型的功率转换器及相关功率电子元件必须严格遵守电气安全规则,要能在恶劣条件下保持正常工作,其鲁棒性能够耐受短路这种危险的临界事件的冲击
没有设备能够监测微秒级功率脉冲引起的器件内部温度升高,当脉冲非常短时,只能用模拟方法估算晶体管结构内部和相邻层的温度上升。此外,温度估算及其与已知临界值的相关性将能解释实验观察到的失效模式。
在这种情况下,模拟工具和分析方法起着重要作用,因为了解在极端测试条件下结构内部发生的现象,有助于解决如何强化技术本身的鲁棒性问题,从而节省开发时间[2],[3]。
本文简要介绍了650V、45mΩ碳化硅功率MOSFET样品的短路实验,以及相关的失效分析和建模策略。
短路试验分析与结构模拟
在做短路实验(SCT)前,先用电压电流曲线测量仪对待测样品的栅极氧化层进行完整性测试,如图1(a)所示。然后,对待测器件进行动态表征测试,评估其开关特性。 图1(b)所示是典型开关表征的等效电路图。图1(c)所示是相关实验的波形:Vgs、Vds、Id,以及在VDD = 400V、20A负载电流、Vgs=-5/20V、Rg =4.7Ω关断时的功率分布Poff。计算出关断能量Eoff,取值约25mJ。
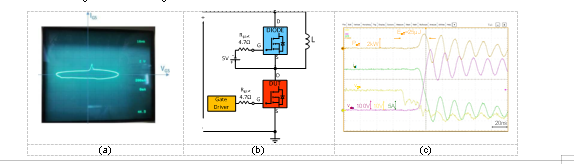
图1(a)栅极氧化层测量,(b)开关表征等效电路(c)典型的关断波形
图2(a)所示是短路实验的试验台,图2(b)所示是实验等效电路图。

图3(a)所示是样品1在失效条件下的短路实验波形。施加一串时间宽度增量为250ns的单脉冲达到失效点。观察到脉冲间延迟为5秒。在VDD = 400V、Vgs = 0/20V和Rg =4.7Ω的条件下,样品1顺利完成tsc=5,75ms脉冲短路实验。
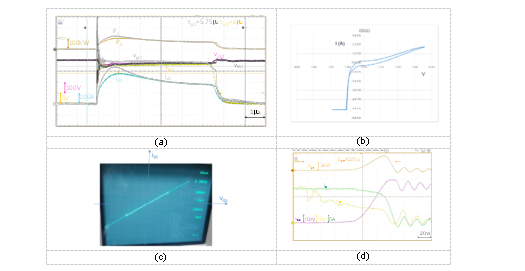
图3(a)短路试验动态波形 (b)和(c)栅极氧化层电学表征
(d)短路试验导致栅极氧化层退化后的关断波形
在这个时步里,脉冲无法显示失效模式,需要在下一个时步(tsc=6ms)中去验证,此时,栅极氧化层被不可逆地损坏。观察到漏极电流Id和Vgs下降(图3(a))。在图3(b)中观察到的损坏是短路能量(Esc)过高导致的栅极氧化层失效,并且用曲线测量仪证实失效存在,如图3(c)所示。观察到的栅极氧化层退化与Eoff性能的动态变化相关,如图3(d)所示。
随后,对失效器件进行失效分析,在后侧和前侧用光电子能谱确定缺陷位置,并用聚焦离子束方法进行“热点”截面分析。 图4所示的物理缺陷本质上是多晶硅层熔化,与电废料一致。

表1总结了测试器件中两个样品的实验结果,从测量结果看,两个样品的损耗程度不同。 样品1的本征栅源电阻为3.3kΩ,除连续栅极电流吸收异常外,MOSFET的其它功能未受任何影响。相对于标准操作条件,样品2本征栅源电阻低很多,而栅极吸收电流却升高。即使开关能量在受损严重的样品上显著提高,两个样品仍然能够维持功能正常,如图3(d)所示。
表1短路实验终结果和样品特性。
|
样品 |
Vth [V] @1mA |
RDSON [mΩ] @ VGS=20V ID=20A |
栅极氧化层完整性 |
EOFF [mJ] @ VDS=400V, VGS=-5/20V RG=4.7Ω, ID=20A |
tsc [ms] |
||||
|
|
实验前 |
试验后 |
实验前 |
试验后 |
实验前 |
试验后 |
实验前 |
试验后 |
|
|
1 |
2.74 |
2.4 |
46.4 |
46.5 |
正常 |
失效 RGS=3.3kΩ |
25 |
28 |
6 |
|
2 |
2.57 |
0 |
44 |
/ |
正常 |
Fail. RGS=18Ω |
26 |
220 |
5.75 |
因此,为了解释失效机理,我们使用Silvaco工具[4]在短路实验静态条件下进行结构模拟,如图5(a)所示,并且提取了碳化硅结构内部电压/电流密度分布数据,如图5(b)所示。 在Atlas(用于器件模拟的Silvaco工具)中,FE器件的栅极偏压20V,漏极触点偏压400V。使用实验数据集微调传导模型,以便在饱和条件下也能取得适合的阈值电压或I-V特性。栅极氧化层与碳化硅界面处的状态能量密度分布,各向异性迁移率值和电子饱和速度,是在实验数据和模拟输出之间实现良好匹配的关键参数。 传导模型可提供在短路实验期间芯片上耗散功率的分布,所以传导模型微调对建模策略具有非常重要的意义。

图5 Silvaco工具:(a)模拟的垂直剖面图 (b)功率分布图
本文提出的建模方法就是,使用Silvaco工具进行结构模拟,根据模拟输出的功率分布数据,为有限元方法(Comsol Multiphysics[5])物理模型提供随时间变化的功率分布实验数据。 该模型专门用于研究类似于持续几微秒的短路类事件,理解并解释在短功率脉冲期间碳化硅MOSFET结构内部发生的情况,同时将碳化硅的热特性(热导率和热容量)视为温度的函数。利用这个新模型研究内部结构的热行为,并评估结和周围层的温度。图6(a)和图6(b)所示是温度达到峰值时的热图和热通量,指示了温度所在的位置(图6(a))以及在整个结构内部热量是如何传递的(图6(b))。热分布可发现短路试验主要涉及器件的哪些部分,解释实验观察到的失效模式。图6(c)显示了不同层的温度分布与时间的关系:温度峰值是结构顶层的温度,与当前已知的临界值一致[6]。

结论
本文创建的有限元热模型考虑到了MOSFET的物理结构和试验数据。该建模方法能够估算在短功率脉冲特别是短路实验条件下,结和周围层中的温度分布情况,解释了实验观察到的失效现象。
鉴于没有设备能够准确地检测到如此短暂的脉冲在被测器件上产生的温度上升,并且典型热模型是为量产封装或系统器件开发的,无法有效地用于分析此类事件,因此,试验结果对建模策略实施具有非常重要的意义。
版权与免责声明
凡本网注明“出处:维库电子市场网”的所有作品,版权均属于维库电子市场网,转载请必须注明维库电子市场网,https://www.dzsc.com,违反者本网将追究相关法律责任。
本网转载并注明自其它出处的作品,目的在于传递更多信息,并不代表本网赞同其观点或证实其内容的真实性,不承担此类作品侵权行为的直接责任及连带责任。其他媒体、网站或个人从本网转载时,必须保留本网注明的作品出处,并自负版权等法律责任。
如涉及作品内容、版权等问题,请在作品发表之日起一周内与本网联系,否则视为放弃相关权利。
- xEV 主逆变器电源模块中第四代 SiC MOSFET 的短路测试2024/4/26 17:31:11
- 定义绝缘耐久性评估的电压脉冲测试要求2024/4/26 16:36:19
- Keysight - 是德科技联合 ETS Lindgren 推出创新 NB-NTN OTA 测试解决方案2024/4/25 15:59:02
- 三坐标测量仪使用步骤及注意事项2024/4/11 17:54:47
- 如何提高接地电阻2024/4/11 16:38:47
- 英特尔数据存储如何操作和实现
- 什么是微动开关_微动开关有什么用_微动开关使用方法
- VCC,VDD,VEE,VSS在电源原理图中有什么区别?
- 低压配电系统设计规范_低压配电系统设计注意事项
- xEV 主逆变器电源模块中第四代 SiC MOSFET 的短路测试
- 光耦详细应用教程
- 定义绝缘耐久性评估的电压脉冲测试要求
- 采用沟槽MOS结构,使存在权衡关系的VF和IR相比以往产品得到显著改善 ROHM推出实现业界超快trr的100V耐压SBD“YQ系列”
- NOVOSENSE - 纳芯微推出车规级温湿度传感器NSHT30-Q1,助力汽车智能化发展
- Keysight - EV 电池设计创新:扩大续航里程、延长电池寿命









