拆解SDRAM存储器 三星与SK海力士与众不同
出处:电子工程专辑 发布于:2013-06-20 10:28:21
根据拆解分析机构Techinsights近对目前市面上先进DRAM存储器单元(cell)技术所做的详细比较分析发现,虽然已有部分预测指出DRAM存储器单元将在30纳米制程遭遇微缩极限,但各大DRAM制造商仍将持续朝2x纳米甚至1x纳米节点前进。
Techinsights近分析了包括三星(Samsung)、SK海力士(Hynix)、美光 (Micron)/南亚(Nanya)与尔必达(Elpida)已量产的3x纳米SDRAM存储器单元阵列结构之制程技术与元件架构,推论该技术仍有进一步微缩的空间,而共同解决方案是结合埋入式字线(buried wordlines,b-WL)与鳍状存取晶体管(fin-shaped access transistors)。
Techinsights指出,在DRAM单元架构发展时程表上,目前的低3x纳米节点在制程技术整合上的重要元素,是如何有效提升存取MOSFET的通道长度(channel length),以及如何将DRAM单元阵列上的储存电容区域(storage capacitor area)微缩。
而拥有鞍型(saddle shaped)──或大型鳍式(bulky fin-type)──通道配置的埋入式金属字元线,是推动3x/2x纳米存取晶体管继续微缩的关键解决方案,因为具备控制良好的阈值电压(threshold voltage)以及超低泄漏电流;此外,该种架构的元件具备较大通道宽度与长度,对短通道效应与较高的启动电流(on-current)有较佳的免疫力。
上述四家存储器厂商都是采用类似的制程生产内凹(recess)、鳍式晶体管;该种鳍状晶体管如下图所示。美光与SK海力士的大型鳍式晶体管外观有点类似梯形,而根据整合通道宽度与长度的估计,美光/南亚的单元晶体管通道宽度,尔必达晶体管的通道长度是长的。
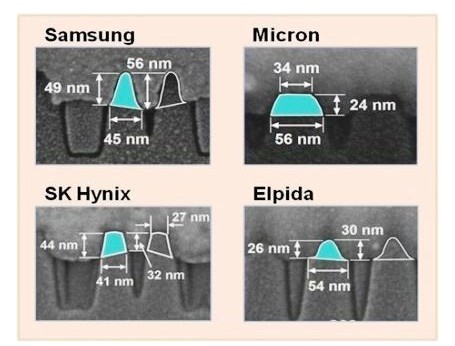
比较三星、SK海力士、美光/南亚与尔必达四家厂商的存储器单元晶体管架构
在埋入式字元线栅极材料部分,三星是采用电阻高于钨(tungsten,化学符号为W)的TiN金属,与其他三家厂商不同;在字元线堆叠部分,所有厂商的存储器元件都是采用以钨为基础的材料,不过钨层与多晶硅层之间的屏障材料,则各家厂商都不相同。
为了微缩储存电容,金属-绝缘-金属(metal-insulator-metal ,MIM)电容器需要相对应于约当次1纳米厚度二氧化硅(SiO2)的特定电容量,以及高K电介质(high-k dielectrics)、超低泄漏电流,以及高度保角(highly conformal)沉积方法。
在二氧化锆(ZrO2)层之间加入一层超薄的三氧化二铝(Al2O3),以及W/TiN电极,是制作3x纳米存储器单元的关键解决方案。Techinsights指出,所有存储器大厂都通过采用相同的TiN (阳极)-ZrO2-Al2O3-ZrO2-TiN (底层电极)多层堆叠电容──称为ZAZ-TIT电容,来克服3x纳米存储器单元的制造挑战(如下图)。

各家厂商的存储器单元电容结构
在二氧化锆层之间加入薄薄的三氧化二铝,是为了抑制泄漏电流;该电介质在3D圆柱状电容器节点的物理厚度,则是制程进一步微缩的另一个挑战。大多数3x纳米DRAM单元电容器,是采用整体厚度约7~9纳米的多层式电介质,这意味着未来1x纳米DRAM单元架构将会迫切需要进一步缩减该物理性电介质厚度。
多数厂商在TiN顶部电容器上采用硅锗(SiGe)层,除了美光/南亚是采用钨层。SK海力士采用了双层式的多晶硅插栓(plug),来连结储存节点与汲极区(drain region),尔必达则是采用双层W/TiN与多晶硅插栓。
采用机械强化储存高度(Mechanically Enhanced Storage Height,MESH)结构可增加存储器单元的高度,以支撑电容器;三星、SK海力士与尔必达在这部分都是采用单层氮化物,美光/南亚则是采用双层氮化物来支撑圆柱状电容。根据估算,SK海力士的SDRAM20单元比其他厂商元件拥有更大的存储器单元电容量。
Techinsights的拆解分析也发现,大多数埋入式字元线SDRAM元件,在阵列区(array region)都是采用三阱制程(triple well process);这种技术是在p型基板上,将一个p型阱(p-well)嵌入到n型阱(n-well)中。
不过美光/南亚的31纳米SDRAM单元阵列,则是采用“四阱(quadruple well)”制程,也就是在一个较深的p型阱上,将一个较浅的p型阱嵌入较深的n型阱,该较深的p型阱则是位于轻微掺杂(lightly doped)的块状n型基板内。
由该种6F2 存储器阵列单元的布局图来看,不同厂商元件的活性(active)/浅沟渠隔离(Shallow trench isolation,STI)形状、倾斜角度(slanted angle)与字元线沉积各自不同,如下图所示。
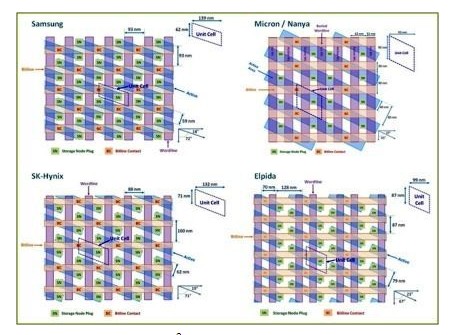
各家厂商6F2 存储器单元阵列布局图比较
三星与SK海力士拥有相同的交错虚线(staggered dash-line)形式活性区布局设计,与美光/南亚的直线式活性区布局不同,但前者需要额外的隔离字元线。美光/南亚元件的活性区图案倾斜角度比其他厂商都大,这意味着记忆体单元的储存节点触点(storage node contact)与STI间距(pitch)有更大的空间可以利用。
为应对来自智能手机、平板等非PC装置对DRAM的强劲需求,以及PC用DRAM市场的稳定成长,DRAM存储器单元架构的进一步微缩确实有其必要。
拜新一代半导体制程与元件设计技术之赐──包括高数值孔径氟化氩(high-NA ArF)浸润式微影技术与双重图形(double patterning)、大型鞍鳍式晶体管(bulky saddle-fin transistors )与埋入式字元线等──DRAM单元阵列可望持续朝30纳米甚至20纳米节点以下微缩。
有一种无电容(capacitor-less) DRAM单元架构,包括将浮体单晶体管DRAM (1T-DRAM)结合绝缘上覆硅(SOI)技术,正在针对20纳米以下制程节点进行开发;同时,所谓的1T-1C(单晶体管-单电容) DRAM存储器单元制程整合技术也已经足够成熟,可运用于20纳米甚至20纳米以下节点,只要产业界能开发出、并进一步化电容电介质。
拥有较大的通道长度与宽度之无捕陷(Trap-free)超高介电值(ultra high-k)材料与更深的埋入式字元线架构也有其必要;为了迈向1x纳米DRAM存储器单元阵列,产业界将会需要锁定替代性的单元设计架构,例如42 、垂直单元架构,以及用薄体SOI无电容单元(thin-body SOI capacitor-less cel)取代目前具备圆柱形电容的埋入式字元线鞍鳍式FET.
版权与免责声明
凡本网注明“出处:维库电子市场网”的所有作品,版权均属于维库电子市场网,转载请必须注明维库电子市场网,https://www.dzsc.com,违反者本网将追究相关法律责任。
本网转载并注明自其它出处的作品,目的在于传递更多信息,并不代表本网赞同其观点或证实其内容的真实性,不承担此类作品侵权行为的直接责任及连带责任。其他媒体、网站或个人从本网转载时,必须保留本网注明的作品出处,并自负版权等法律责任。
如涉及作品内容、版权等问题,请在作品发表之日起一周内与本网联系,否则视为放弃相关权利。
- 虚拟存储器的概念和特征2025/8/4 16:49:21
- 铁电存储器和flash的区别2025/7/30 16:56:02
- 内存频率是什么_内存频率高有什么好处2025/7/29 17:07:27
- 程序存储器_程序存储器是什么意思2025/7/10 17:26:01
- 揭秘专为 SSD 固态硬盘定制的高性能 PMIC2025/7/7 15:35:35









