长电成功抢单日月光半导体 详解SIP封装与Soc
出处:雷锋网 发布于:2015-12-01 10:24:19
日前,江苏长电科技成功击败台湾日月光半导体,和日本村田一同获得苹果SIP模块订单,而且长电科技斩获的订单比例超过订单总额的50%以上。这是自长电科技以7.8亿美元(其中集成电路大基金出资1.4亿美元,中国银行贷款1.2亿美元)收购新加坡星科金朋以来重大胜利。受此鼓舞,长电科技投资2亿美元扩充厂内SiP模块封测生产线,以完成苹果以亿为单位计算的订单。

那么什么是SIP呢?和我们熟知的SoC有何差别呢?

(错综复杂的收购资本来源,至于背后真正的主使者,你懂得)
SoC和SIP
自集成电路器件的封装从单个组件的开发,进入到多个组件的集成后,随着产品效能的提升以及对轻薄和低耗需求的带动下,迈向封装整合的新阶段。在此发展方向的引导下,形成了电子产业上相关的两大新主流:系统单芯片SoC(System on Chip)与系统化封装SIP(System in a Package)。
SoC与SIP是极为相似,两者均将一个包含逻辑组件、内存组件,甚至包含被动组件的系统,整合在一个单位中。
SoC是从设计的角度出发,是将系统所需的组件高度集成到一块芯片上。
SIP是从封装的立场出发,对不同芯片进行并排或叠加的封装方式,将多个具有不同功能的有源电子元件与可选无源器件,以及诸如MEMS或者光学器件等其他器件优先组装到一起,实现一定功能的单个标准封装件。
构成SIP技术的要素是封装载体与组装工艺,前者包括PCB、LTCC、Silicon Submount(其本身也可以是一块IC),后者包括传统封装工艺(Wire bond和Flip Chip)和SMT设备。无源器件是SIP的一个重要组成部分,如传统的电容、电阻、电感等,其中一些可以与载体集成为一体,另一些如高、Q值高、数值高的电感、电容等通过SMT组装在载体上。

(SIP封装)
从集成度而言,一般情况下,SoC只集成AP之类的逻辑系统,而SiP集成了AP+mobile DDR,某种程度上说SIP=SoC+DDR,随着将来集成度越来越高,emmc也很有可能会集成到SIP中。
从封装发展的角度来看,因电子产品在体积、处理速度或电性特性各方面的需求考量下,SoC曾经被确立为未来电子产品设计的关键与发展方向。但随着近年来SoC生产成本越来越高,频频遭遇技术障碍,造成SoC的发展面临瓶颈,进而使SIP的发展越来越被业界重视。
SIP的封装形态
SIP封装技术采取多种裸芯片或模块进行排列组装,若就排列方式进行区分可大体分为平面式2D封装和3D封装的结构。相对于2D封装,采用堆叠的3D封装技术又可以增加使用晶圆或模块的数量,从而在垂直方向上增加了可放置晶圆的层数,进一步增强SIP技术的功能整合能力。而内部接合技术可以是单纯的线键合(Wire Bonding),也可使用覆晶接合(Flip Chip),也可二者混用。
另外,除了2D与3D的封装结构外,还可以采用多功能性基板整合组件的方式——将不同组件内藏于多功能基板中,达到功能整合的目的。不同的芯片排列方式,与不同的内部接合技术搭配,使SIP的封装形态产生多样化的组合,并可依照客户或产品的需求加以客制化或弹性生产。
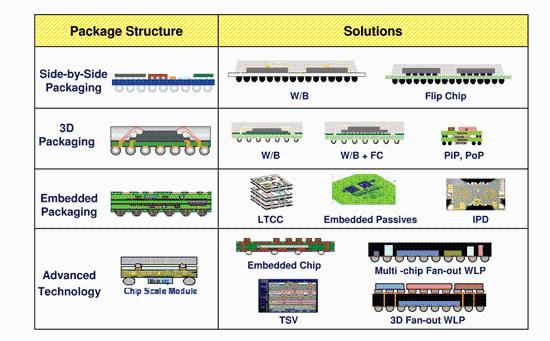
(几种SIP封装方案)
SIP的技术难点
SIP的主流封装形式是BGA,但这并不是说具备传统先进封装技术就掌握了SIP技术。
对于电路设计而言,三维芯片封装将有多个裸片堆叠,如此复杂的封装设计将带来很多问题:比如多芯片集成在一个封装内,芯片如何堆叠起来;再比如复杂的走线需要多层基板,用传统的工具很难布通走线;还有走线之间的间距,等长设计,差分对设计等问题。
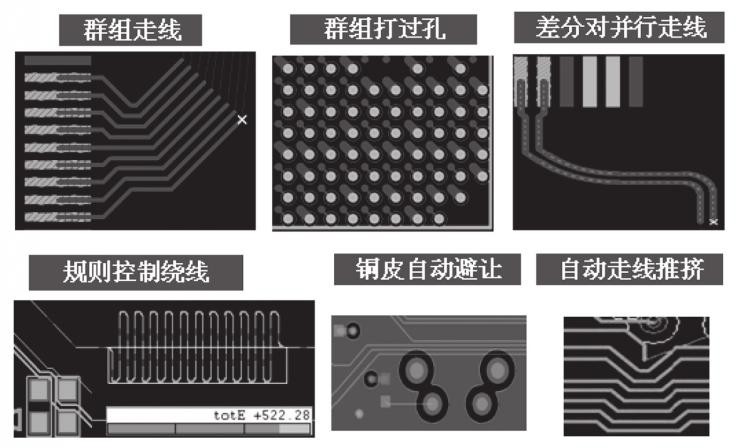
此外,随着模块复杂度的增加和工作频率(时钟频率或载波频率)的提高,系统设计的难度会不断增加,设计者除具备必要的设计经验外,系统性能的数值仿真也是必不可少的设计环节。
SIP封装技术市场前景如何?
与在印刷电路板上进行系统集成相比,SIP能限度地优化系统性能、避免重复封装、缩短开发周期、降低成本、提高集成度。相对于SoC,SIP还具有灵活度高、集成度高、设计周期短、开发成本低、容易进入等特点。
SIP封装可将其它如被动组件,以及天线等系统所需的组件整合于单一构装中,使其更具完整的系统功能。由应用产品的观点来看,SIP更适用于低成本、小面积、高频高速,以及生产周期短的电子产品上,尤其如功率放大器(PA)、定位系统、蓝芽模块(Bluetooth)、影像感测模块、记忆卡等可携式产品市场。
正因为SIP封装具有灵活度高、集成度高、相对低成本、小面积、高频高速、生产周期短的特点,SIP封装技术不仅可以广泛用于工业应用和物联网领域,在手机以及智能手表、智能手环、智能眼镜等领域也有非常广阔的市场。
目前智能硬件厂商在设计智能可穿戴设备时,主要面临的挑战是如何将众多的需求功能全部放入极小的空间内。以智能眼镜为例,在硬体设计部分就须要考量无线通讯、应用处理器、储存记忆体、摄影镜头、微投影显示器、感应器、麦克风等主要元件特性及整合方式,也须评估在元件整合于系统板后的相容性及整体的运作效能。
而运用SIP系统微型化设计,能以多元件整合方式,简化系统设计并满足设备微型化。在不改变外观条件下,又能增加产品的可携性和无线化以及即时性的优势。
目前全世界封装的产值只占集成电路总值的10%,而SIP的出现很可能将打破目前集成电路的产业格局,改变封装仅仅是一个后续加工厂的状况。未来集成电路产业中也许会出现一批结合设计能力与封装工艺的实体,掌握有自己品牌的产品和利润。当SIP技术被封装企业掌握后,封装业的产值可能会出现一定幅度的提高。
版权与免责声明
凡本网注明“出处:维库电子市场网”的所有作品,版权均属于维库电子市场网,转载请必须注明维库电子市场网,https://www.dzsc.com,违反者本网将追究相关法律责任。
本网转载并注明自其它出处的作品,目的在于传递更多信息,并不代表本网赞同其观点或证实其内容的真实性,不承担此类作品侵权行为的直接责任及连带责任。其他媒体、网站或个人从本网转载时,必须保留本网注明的作品出处,并自负版权等法律责任。
如涉及作品内容、版权等问题,请在作品发表之日起一周内与本网联系,否则视为放弃相关权利。
- 51单片机和52单片机有什么区别2025/8/8 16:52:42
- DSP与单片机到底有什么区别2025/7/28 17:02:00
- 单片机的三种总线结构2025/7/24 17:04:09
- 单片机芯片封装类型有哪些?2025/7/17 17:07:52
- C51 单片机使用避坑指南:误区与注意事项全解析2025/7/9 10:30:49









